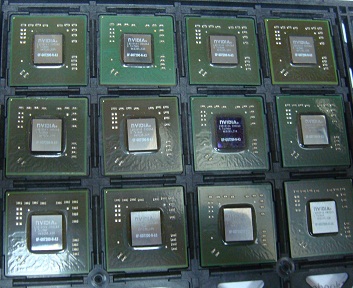 Подготовка подложки к осаждению начинается с того, что ее тщательно шлифуют и полируют методами механической полировки или путем травления. После этого ее очищают (часто с использованием ультразвука) и промывают. В вакуумной камере подложки часто подвергаются дополнительной очистке путем ионной бомбардировки.
Подготовка подложки к осаждению начинается с того, что ее тщательно шлифуют и полируют методами механической полировки или путем травления. После этого ее очищают (часто с использованием ультразвука) и промывают. В вакуумной камере подложки часто подвергаются дополнительной очистке путем ионной бомбардировки.
Высокая чистота подложки и тщательная ее шлифовка и полировка являются основными условиями обеспечения хорошего сцепления пленки с подложкой и высокого качества пленки.
Маскирование. Для получения нужной геометрической формы и размеров пленочных компонентов интегральных схем используется процесс маскирования.
Маскирование включает в себя изготовление масок и нанесение или удаление (путем травления) пленок через них. Имеется два основных вида масок: металлические и фоторезистивные. Для получения фоторезистивной маски подложку, используют станок плазменной резки с чпу на который необходимо нанести такую маску, покрывают тонким слоем специальной защитной фоточувствительной эмульсии — фоторезиста (наиболее широко используются фоторезисты KPR, KMER, KTFR фирмы Kodak — США), который соответствующим образом обрабатывают и подготавливают к засвечиванию.
При этом области нужной глубины формируются с поверхности полупроводниковой пластины. Кроме того, основные технологические процессы обеспечивают также выращивание на поверхности полупроводниковой пластинки или другой подложки полупроводниковых пленок требуемой толщины, также имеющих проводимости различных типов и концентраций.
Как и в случае тонких пленок, известно большое число полупроводниковых материалов, которые можно использовать для изготовления интегральных схем, однако в настоящее время практически используется, главным образом, монокристаллический кремний. Это объясняется двумя причинами: во-первых, хорошей стабильностью и хорошими характеристиками компонентов интегральных схем, изготовленных на основе монокристаллического кремния, и, во-вторых, хорошими защитными свойствами двуокиси кремния Si02, предохраняющей поверхности сформированных в кремнии электронно-дырочных переходов и обеспечивающей применение маскирования во время технологических процессов изготовления этих переходов.
